半導體(ti) 封測主流技術及發展方向分析
近幾年,中國半導體(ti) 產(chan) 業(ye) 繼續維持高速增長態勢,增長率超過了20%;IC設計、封測、晶圓製造以及功率器件是為(wei) 4大推動主力。
其中,封測行業(ye) 在過去十多年中,因成本比較高,主要靠量推動發展,並是過去我國半導體(ti) 產(chan) 業(ye) 4大推動力中產(chan) 值較高的一塊。
不過,近兩(liang) 年來,我國的IC設計行業(ye) 獲得了巨大發展,2018年其產(chan) 業(ye) 營收已經超過了2500億(yi) 人民幣規模,超過了封測產(chan) 業(ye) 的產(chan) 值,未來還將繼續高速發展。由此,封測行業(ye) 也將繼續成長,以匹配正在高速發展的IC設計行業(ye) 發展需求。
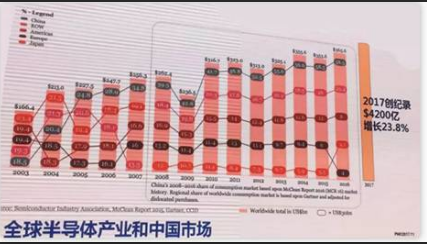
從(cong) 行業(ye) 發展曆程來看,包括封測行業(ye) 在內(nei) 的半導體(ti) 產(chan) 業(ye) 主要由幾類代表性產(chan) 品所驅動。在上世紀80年代中期,由計算機主機和台式電腦推動發展;這一時期,筆記本電腦的發展勢頭也開始慢慢展現。而到了上世紀90年代中期,筆記本電腦就成為(wei) 了整個(ge) 半導體(ti) 產(chan) 業(ye) 的驅動主力。待進入千禧之年,以手機為(wei) 代表的移動通訊產(chan) 品開始引領半導體(ti) 產(chan) 業(ye) 的高速成長。在2010年之後,集各種功能於(yu) 一體(ti) 的智能手機取代了上一代產(chan) 品並高速成長,並成為(wei) 當下半導體(ti) 產(chan) 業(ye) 發展的驅動代表。封測行業(ye) 正是伴隨這些時代的產(chan) 品升級而獲得了巨大發展。

下一個(ge) 驅動半導體(ti) 產(chan) 業(ye) 繼續繁榮的代表產(chan) 品又是什麽(me) 呢?目前主流觀點認為(wei) ,數據運算時代將會(hui) 成為(wei) 當下的驅動主力,這是因為(wei) 在端對端的應用中,如手機平台、汽車平台、智能製造、智能家居等,將會(hui) 構建邊緣雲(yun) 計算的龐大網絡,形成端應用,這就需要龐大的大數據運算能力,離不開5G、AI、雲(yun) 計算等技術的支撐。
麵對新的產(chan) 業(ye) 變化,封測行業(ye) 該如何應對?需要哪些新的技術來匹配發展?
雲(yun) 端應用需要非常寬的帶寬,我們(men) 知道,摩爾定律及先進製程一直在推動半導體(ti) 行業(ye) 的發展,封裝行業(ye) 也需要新的技術來支持新的封裝需求,如高性能2.5D/3D封裝技術、晶圓級封裝技術、高密度SiP係統級封裝技術、高速5G通訊技術以及內(nei) 存封裝技術等,這些將會(hui) 成為(wei) 接下來封裝行業(ye) 跟進產(chan) 業(ye) 潮流的主流技術及方向。
2.5D/3D先進封裝集成
目前,需要從(cong) FcBGA等平台上提供最大的封裝尺寸,從(cong) 傳(chuan) 統的2.5D封裝提供轉接板工藝開始,深入開發及提供低成本方案,比如長電科技的UFOs基板技術,既可以替代原來的基板,也可以在基板中增加一層薄膜,還可以作為(wei) 高密度的封裝方案,從(cong) 而降低封裝的成本,並提高產(chan) 品的性價(jia) 比。

晶圓級封裝技術
晶圓級封裝技術應用非常廣泛,成長也非常迅速,目前可以做到8英寸、12英寸多層封裝。該技術還可以用來實現Remain封裝,可以很好地提高產(chan) 品的可靠性。
其中,Fan-Out技術是當下晶圓級封裝技術中的熱門,這需要利用晶圓級平台來實現,星科金鵬推出的eWLB正是Fan-Out技術方案之一,DECA和近幾年台積電采用的InFo也是行業(ye) 重要的晶圓級Fan-Out封裝方案。
eWLB和FO-ECP是長電科技目前施行的主要方案,其中eWLB屬於(yu) 通用級技術,使用領域廣泛;而FO-ECP為(wei) 長電科技專(zhuan) 門開發的新技術,能對封裝體(ti) 提供支持,側(ce) 重於(yu) 尺寸比較小的產(chan) 品的封裝,主要麵對消費級、功率器件領域產(chan) 品。
當然,利用Fan-Out方案也可以為(wei) 高密度芯片互聯結構設計提供支持,這是一種偏向於(yu) 芯片工藝的封裝技術,可在晶圓層麵實現局部優(you) 化,通過互聯技術,將不同的芯片結合在一起。
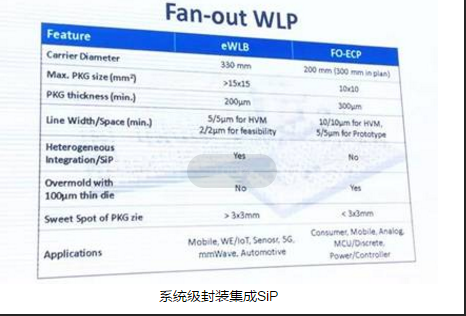
係統級封裝是目前各封裝企業(ye) 著力發展的重要技術,其驅動力主要來自兩(liang) 個(ge) 方麵,一是摩爾定律邁向收官階段,行業(ye) 的發展越來越困難;值得慶幸的是,目前有消息稱,基於(yu) 矽基技術,摩爾定律有望延後到2040年才會(hui) 終結,當然,越往後,每一次技術進步所付出的成本會(hui) 越來越高。另一方麵就是通過係統級封裝集成技術來實現更為(wei) 精密的生產(chan) 製造,從(cong) 而可以推出不同的器件、不同功能的元件,如2D、3D、多層疊加等技術,將現有的技術運用起來,形成封裝係統集成。
目前蘋果產(chan) 品在係統級封裝領域已經走在了行業(ye) 前列,其手機產(chan) 品中采用到係統級封裝的元器件幾乎占到了整個(ge) 產(chan) 品的一半,剩下的一半為(wei) 晶圓級封裝。模塊化產(chan) 品設計已經成為(wei) 蘋果公司的標配;他的這一動作,為(wei) 封裝行業(ye) 的發展指明了道路,也影響了行業(ye) 的產(chan) 品設計走向,目前三星、華為(wei) 、索尼、小米等企業(ye) 也在慢慢往係統級封裝領域靠攏。

係統級封裝技術可以解決(jue) 目前我們(men) 遇到的很多問題,其優(you) 勢也是越來越明顯,如產(chan) 品設計的小型化、功能豐(feng) 富化、產(chan) 品可靠性等,產(chan) 品製造也越來越極致,尤為(wei) 重要的是,提高了生產(chan) 效率,並大幅降低了生產(chan) 成本。
未來,係統級封裝將在小型化、高密度封裝、散熱方麵發揮越來越重要的作用。當然,難點也是存在的,係統級封裝的實現,需要各節點所有技術,而不是某一技術所能實現的,這對封裝企業(ye) 來說,就需要有足夠的封裝技術積累及可靠的封裝平台支撐,如高密度模組技術、晶圓級封裝技術等。
而且,針對不同產(chan) 品,封裝技術也不同,如手機的RF模塊,其上集成了不同的芯片、不同的元器件等,每一種元件對封裝的要求都不一樣,這就要求封裝企業(ye) 要有足夠的技術和經驗來應對。
5G高速通信封裝
當下,與(yu) 係統級封裝技術緊密相連的應用正是5G通信。5G的標準有三大塊:5G毫米波、<6GHz的5G技術、5G IOT,它們(men) 都要求端對端高速連接,進而要求產(chan) 品要具備較高的頻率,當然也會(hui) 造成因波長變短而衍生的新問題,如5G手機的噪聲將會(hui) 變大,這隻能通過將天線與(yu) 手機芯片直接集成來解決(jue) ,這本質上就是係統級封裝在特定領域的應用。
當下,與(yu) 係統級封裝技術緊密相連的應用正是5G通信。5G的標準有三大塊:5G毫米波、<6GHz的5G技術、5G IOT,它們(men) 都要求端對端高速連接,進而要求產(chan) 品要具備較高的頻率,當然也會(hui) 造成因波長變短而衍生的新問題,如5G手機的噪聲將會(hui) 變大,這隻能通過將天線與(yu) 手機芯片直接集成來解決(jue) ,這本質上就是係統級封裝在特定領域的應用。
正因為(wei) 5G時代即將到來,封裝企業(ye) 針對5G封裝技術的開發,正處於(yu) 激烈的競爭(zheng) 階段。目前不同的企業(ye) ,其封裝技術也不一樣,如陶瓷晶圓級技術方案等。
在5G封裝應用中,電磁輻射的影響也亟需解決(jue) 。5G產(chan) 品的MIMO有很多不同的元件需要同步工作,這會(hui) 造成嚴(yan) 重的電磁幹擾,電磁屏蔽無可避免。目前行業(ye) 主要提供有腔體(ti) 屏蔽、半屏蔽以及全屏蔽三種方案。
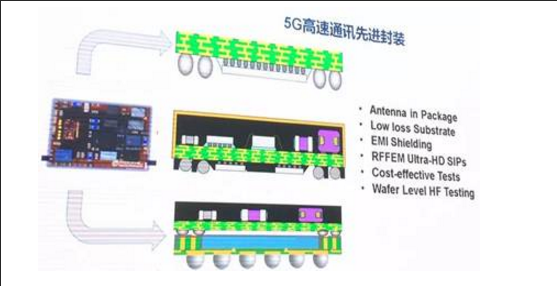
內(nei) 存封裝
內(nei) 存需求依然火爆,目前半導體(ti) 行業(ye) 實現的增長中,絕大部分與(yu) 內(nei) 存有關(guan) ,因此,封裝企業(ye) 也非常關(guan) 注內(nei) 存領域產(chan) 品的封裝。
從(cong) 技術角度看,目前存儲(chu) 封裝主要是堆疊技術,但隨著要求越來越高,Flip Chip、TSV等封裝技術將會(hui) 被越來越多地應用到內(nei) 存封裝上來,包括晶圓級封裝Fan-Out方案。
除了專(zhuan) 門的內(nei) 存封測企業(ye) ,長電科技等通用的封測企業(ye) 也會(hui) 越來越多涉及內(nei) 存封測,堆疊超薄、隱形切割等技術也將會(hui) 更多地得到應用。
由於(yu) 摩爾定律走向困難期,存儲(chu) 封裝更多地引入了3D封裝技術,有效解決(jue) 了2D技術中不大容易被解決(jue) 的問題,通過該技術,目前已經成功封測出了存儲(chu) 空間高達1TB的內(nei) 存產(chan) 品。

聲明:本網站原創內(nei) 容,如需轉載,請注明出處;本網站轉載的內(nei) 容(文章、圖片、視頻)等資料版權歸原網站所有。如我們(men) 采用了您不宜公開的文章或圖片,未能及時和您確認,避免給雙方造成不必要的經濟損失,請電郵聯係我們(men) ,以便迅速采取適當處理措施;郵箱:limeijun@transql.com